


2023年10月26日,第二十一屆中國半導體封裝測試技術與市場年會(CSPT2023)在江蘇昆山盛大開幕。明升ms88湃泰PacTite?受邀出席本次年會,并發表《明升ms88湃泰PacTite?功率半導體封裝漿料解決方案》主題演講,分享了明升ms88湃泰PacTite?功率半導體封裝漿料的最新研發成果與應用實踐。

本屆年會以“‘敢’字為先,謀封測產業新發展”為主題,來自全球各地的2300余名產業界人士齊聚昆山。大會分為兩個專題:封裝關鍵材料的創新與合作、封裝測試與工藝設備的創新和機遇。與此相關的行業熱點問題引起業界同行熱烈研討,共同賦能半導體產業鏈進步,推動行業技術創新、學術交流與國際合作。
絕佳電氣及導熱性能,提高操作與設計靈活性
隨著新能源汽車市場的持續增長,智能化逐漸成為用戶需求的必然趨勢。在對更高性能需求的驅動下,符合車規級芯片封裝的高導熱銀膠發揮著越來越重要的作用。明升ms88湃泰PacTite?推出的DECA400系列20-30W/m·K的高導熱高可靠固晶粘接銀漿,具備非常優異的高溫粘接力及高可靠性,可適用于Cu、Ag、PPF各種框架。出色的高溫粘接力顯著優于市場競品,具備MSL1能力,為中小尺寸芯片封裝提供了良好的操作性和設計的靈活性。

可靠穩定,第三代功率半導體的選擇
明升ms88湃泰PacTite?針對功率半導體芯片封裝材料主要聚焦在燒結銀產品線。其中,湃泰PacTite? DECA600系列低溫無壓燒結銀漿產品,燒結溫度低于220℃,具有良好的工藝性(點膠、鋼網印刷)、可燒結性(良好的燒結界面)、高導電率和極低熱阻,可廣泛應用于GaN/SiC功率器件、RF射頻器件、HBLED、IGBT模塊封裝等。除此之外,湃泰PacTite? DECA600系列壓力燒結銀漿產品,已完成內部研發測試,正配合終端客戶進行工藝和可靠性驗證,即將推向市場。

明升ms88湃泰PacTite? DECA600系列低溫無壓燒結銀漿產品
湃泰PacTite? DECA600系列燒結銀,基于明升ms88DKEM?共性導電銀漿技術平臺開發,利用銀粉表面處理技術和銀粉復配技術,為客戶提供自主研發的高性能高可靠性封裝材料。其中,已面向市場推出的明升ms88湃泰PacTite? DECA600-08B120環氧樹脂體系無壓燒結銀,針對細條型GaN PA射頻芯片在熱固化過程中因應力方向不一致導致的芯片側面與燒結銀粘結開裂問題,通過復配增韌型樹脂,在燒結過程中有效緩沖和吸收應力解決了這一問題,在客戶端通過了TCT1000可靠性測試,總體性能已達到進口品牌水平。
助力國產化,核心技術賦能半導體產業鏈協同進步
第三代半導體(GaN、SiC等)的崛起和發展推動了功率器件不斷走向大功率、小型化、集成化和多功能。其中陶瓷覆銅板因為具有較高的導熱性、絕緣性與耐熱性,以及較高的機械強度和與芯片相匹配的熱膨脹系數,是目前最為重要的功率半導體封裝基板材料。
明升ms88湃泰PacTite? DK1200系列AMB陶瓷覆銅板釬焊漿料,具有良好的印刷適用性、優異的抗冷熱沖擊性能、極低的空洞率和可調控的銅層-陶瓷結合力,有效滿足各類高可靠性應用場景的嚴苛需求,適用于Al2O3、AlN、Si3N4、SiC等基材的無氧銅箔高溫互聯工藝,可廣泛應用于航天軍工、軌道牽引(如高鐵等)、輸變電網、全電船舶、新能源汽車等領域。目前已成功實現對進口漿料的國產化替代。
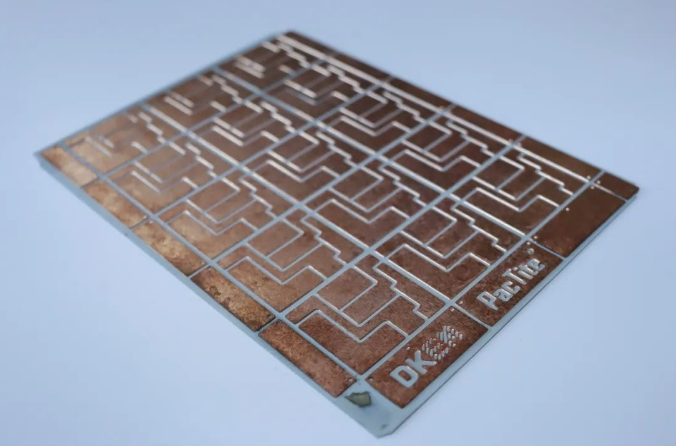
明升ms88湃泰PacTite? DK1200系列AMB陶瓷覆銅板釬焊漿料
緊隨行業技術發展趨勢,明升ms88湃泰PacTite?研發的新一代無銀體系釬焊漿料在多家客戶測試進展順利,也將逐步推向市場。
同時,明升ms88湃泰PacTite?分享了在AMB釬焊漿料應用過程中最為關注的技術難點和痛點,通過分享微觀釬焊層形貌、內部應用檢測和詳盡的數據,從工藝與應用、組織結構與界面空洞、剝離強度、可靠性、蝕刻性等多個方面,展示了明升ms88湃泰PacTite? DK1200系列AMB陶瓷覆銅板釬焊漿料在提升量產產能和良率上具有極具吸引力的技術優勢,受到與會人員的熱烈稱贊。明升ms88湃泰PacTite?已建成AMB陶瓷覆銅板釬焊漿料工藝和可靠性測試平臺,開放給合作伙伴,進行技術評估與樣品測試。
激發無限可能 Inspire The Possibilities。